SK海力士内联重分布层(IRDL)技术可实现更薄、成本更低的封装
编辑:AVA 发布:2020-05-21 10:01随着移动和可穿戴设备的持续增长,对移动内存的需求也在稳步增长,这是低功耗和超薄封装技术是现代半导体行业不可缺少的要素。
SK海力士推出的内联重分配层(IRDL)技术通过使用带有绝缘层和铝的额外金属层来形成布线,从而使IO焊盘可以在需要时自由地重新放置到封装(PKG)引线键合位置。这项技术可以使芯片间的键合更薄,工艺更简单。此外,IRDL是RDL技术之一,其命名是因为整个过程都在FAB内部进行,这与PKG RDL不同。
如下图展示了两个MCP芯片的方法,左侧的“垂直堆叠MCP”是现有技术,其中上部芯片垂直堆叠在下部芯片的焊盘上;右侧是“使用RDL的移位堆栈MCP”通过避开焊盘使用移位堆栈的方法。
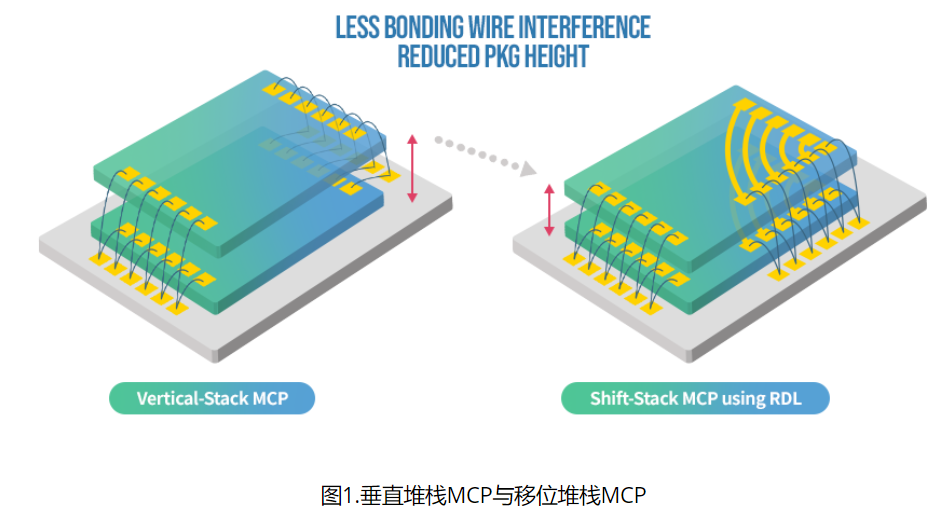
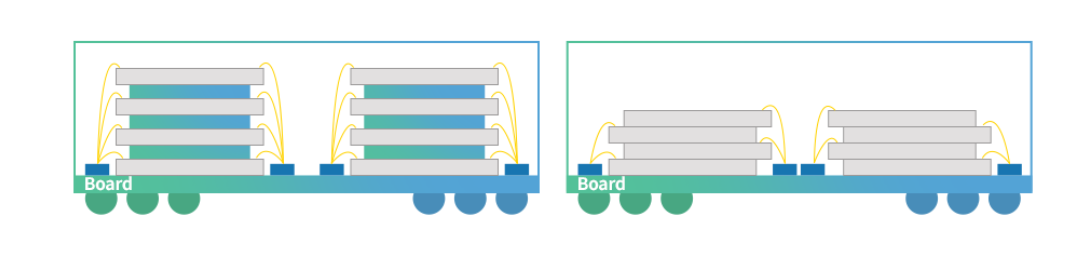
这样,可以防止在垂直堆栈MCP内发生导线干扰和导线与芯片之间的短路。当采用这种新方法时,上层芯片和下层芯片之间的间隙减小,从而大大简化了满足客户要求的适当厚度的过程。
PKG RDL和IRDL之间的主要区别在于结构形成方法,PKG RDL的结构形成方法大致分为两个过程:FAB输入和FAB输出。FAB输入工艺包括仅打开焊盘用绝缘材料覆盖顶部金属。然后,在FAB输出过程中,应用第一介电层将RDL线与晶片顶部的绝缘材料分开,并使用金形成线。之后,施加第二介电层以覆盖线的顶部。
另一方面,在IRDL方法中,使用绝缘材料覆盖顶部金属并形成VIA以打开焊盘。然后,使用铝形成线,这与PKG RDL不同。然后,在上面涂上绝缘材料。
IRDL与PKG RDL具有相同的重定位垫目的。但是,随着FAB内部流程的进行,IRDL具有RDL的三大优势:
- 首先,由于电路可以放置在焊盘下方,因此净裸片得以改善;
- 其次,使用铝代替金可以将整个过程的成本降低多达30%;
- 最后,由于电路设计者可以利用RDL来增强电源网格,因此可以提高芯片的性能。
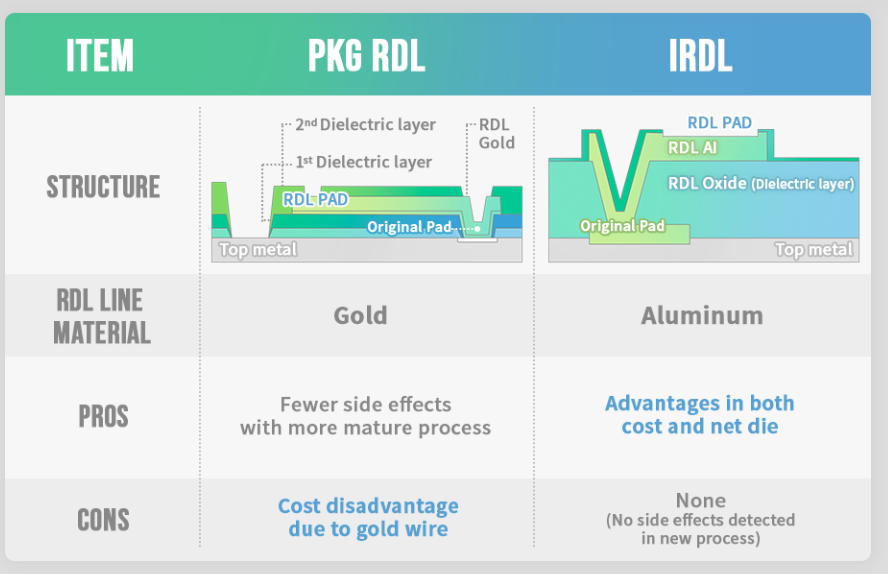
较小的芯片可将电路置于焊盘下方,从而更好地实现净裸
当使用现有的PKG RDL结构时,由于顶部的金属太薄,小于1um,因此在探测和键合期间经常会发生与焊盘有关的许多问题。使用IRDL结构,它可以使顶层金属的厚度几乎达到10um,足以承受探测和键合过程中产生的应力,从而可以将电路放置在焊盘下方。结果,它可以通过减小芯片尺寸来改善净裸片。
使用IRDL加强PDN
使用IRDL的增强型电源网格可增强配电网络(PDN),从而大大提高芯片性能。如果没有IRDL,则只能使用芯片现有的金属布线来进行PDN加固,从而导致远离焊盘的PDN恶化。因此,这种方法的钢筋非常有限。另一方面,当使用IRDL时,由于RDL层的特性,其传递的电阻值较低,因此增强的自由度大大提高了。因此,可以通过使用IRDL来提高芯片的性能。
IRDL:未来设备的前体
IRDL技术实现了低成本流程,其主要目的是将IO焊盘重新放置到PKG所需的位置,而不会损害现有芯片的架构。通过减少成品的厚度,它使企业能够适应移动设备的未来发展方向,即更薄的产品。确保此元素技术对整个行业至关重要,因为它可以通过减小尺寸和增强性能来提高网芯尺寸。

















